随着芯片堆叠技术的快速发展,微电子器件的集成度和功率密度持续攀升,热量积聚问题日益突出,严重影响器件的性能、可靠性和使用寿命。传统散热材料如钼铜合金和碳化硅陶瓷难以同时满足高效散热与高可靠性的要求,且热膨胀系数(CTE)与硅芯片(约4-6×10⁻⁶ K⁻¹)的失配可能导致热应力积累,引发器件失效。金刚石/铜复合材料(D/Cu)结合了铜的可加工性和金刚石的优异特性——超高热导率(2000 W·m⁻¹·K⁻¹)和低热膨胀系数(1×10⁻⁶ K⁻¹),成为下一代热管理材料的理想选择。然而,现有理论模型如Maxwell模型、H-J模型和DEM模型在预测复合材料热导率时存在局限,它们忽略了增强相颗粒的形状以及孔隙引起的界面热导变化,导致与实验数据存在偏差。此外,分子动力学模拟局限于原子尺度,难以研究体材料在微纳米尺度的热传递行为;而现有有限元研究缺乏对复合材料热导率提升的系统研究,忽视了金刚石/铜界面处的声子热传输特性。
研究内容
本研究创新性地引入介观方法——晶格玻尔兹曼方法(LBM),结合宏观有限元方法(FEM),建立了跨越纳米到微米尺度的多尺度热分析框架。研究团队设计了随机分布多边形颗粒的程序,以金刚石/铜复合材料的实验截面图像为指导,构建了二维物理几何模型。在LBM计算中,采用D2Q8晶格结构进行二维热传递计算,考虑了五种典型边界条件(等温边界、周期性边界、水平接触边界、垂直接触边界和角度接触边界),并通过分子动力学模拟计算了金刚石与铜之间的界面热导(ITC)。为验证LBM方法的准确性,研究团队采用声子辐射传热方程(EPRT)在微观和宏观尺度上进行了校准,同时将LBM结果与FEM方法、理论模型(H-J模型和DEM模型)以及文献数据进行了对比验证。
核心发现
研究揭示了金刚石颗粒尺寸对复合材料热导率的显著影响。当颗粒直径小于1 μm时,LBM预测的热导率与有限元结果存在显著偏差(15.9至181.4 W·m⁻¹·K⁻¹),纳米尺度下的热导率趋于零,表明高热导性能丧失。从温度场和声子热流分布可以观察到,在纳米尺度下,声子热传输呈现明显的方向性行为,热量主要通过铜基体传输,金刚石颗粒成为热障而非热导体。随着颗粒尺寸增大,界面接触面积增加,声子在界面的散射和透射概率提高,进入金刚石颗粒的热流随之增加。研究团队发现存在一个临界粒径阈值——当金刚石颗粒尺寸小于22 μm时,颗粒不仅不能提高热导率,反而会阻碍热传递;只有当粒径超过22 μm时,金刚石颗粒才能有效提升复合材料的热导率。这一发现与Kapitza半径理论预测(20 μm)高度吻合。
 图1 不同尺寸金刚石颗粒的热导率变化规律。当颗粒尺寸接近纳米尺度时,热导率急剧下降;当粒径超过22 μm后,热导率显著提升并趋于稳定。
图1 不同尺寸金刚石颗粒的热导率变化规律。当颗粒尺寸接近纳米尺度时,热导率急剧下降;当粒径超过22 μm后,热导率显著提升并趋于稳定。
图1展示了从纳米到微米尺度金刚石颗粒对复合材料热导率的影响规律。当颗粒直径从20 nm增加到90 μm时,热导率呈现先快速上升后缓慢增长的趋势。特别值得注意的是,在22 μm处存在一个临界点——此时复合材料的热导率(401.86 W·m⁻¹·K⁻¹)与纯铜基体相当。这一现象可以通过声子散射理论解释:小尺寸颗粒的尖锐棱角会反射和散射声子,阻碍热量传输;而大尺寸颗粒提供了更连续的导热通路,使声子能够更有效地穿过界面进入金刚石相。
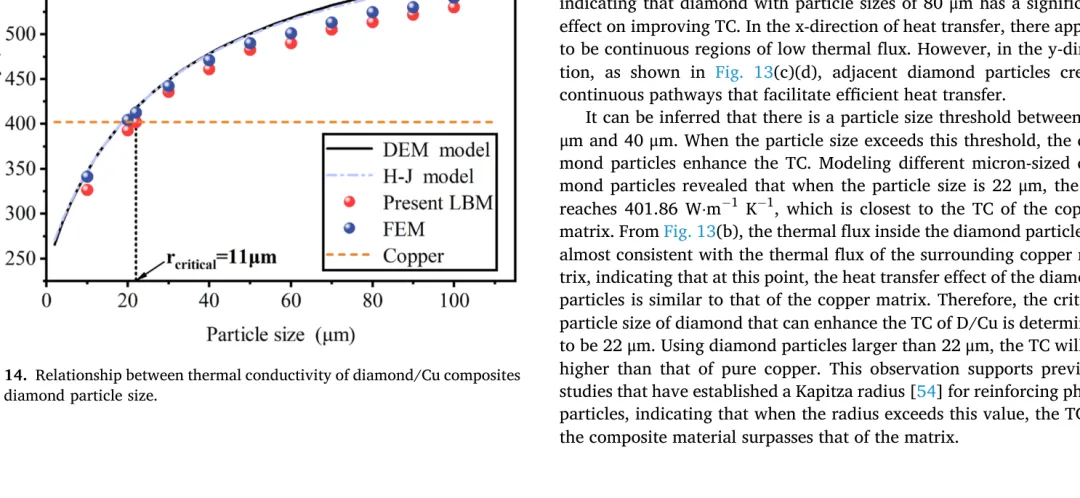 图2 热导率随金刚石颗粒尺寸的变化曲线及与理论模型的对比。LBM结果与DEM和H-J模型趋势一致,但略低于理论预测,这可能是由于理论模型未考虑颗粒形状效应。
图2 热导率随金刚石颗粒尺寸的变化曲线及与理论模型的对比。LBM结果与DEM和H-J模型趋势一致,但略低于理论预测,这可能是由于理论模型未考虑颗粒形状效应。
此外,研究还发现金刚石体积分数对热导率有显著影响。当金刚石含量从10%增加到50%时,复合材料热导率稳步提升;添加48.3 vol%金刚石颗粒可将热导率提升至526.98 W·m⁻¹·K⁻¹,相比纯铜实现31.1%的性能提升。研究还探索了双峰金刚石颗粒的强化效果:在固定主颗粒体积分数(43.7%)的情况下,添加较小的次级金刚石颗粒可以填充主颗粒之间的空隙,进一步提高热导率。当粒径比R=3时效果最佳,添加10.9 vol%次级颗粒可使热导率达到792.7 W·m⁻¹·K⁻¹。然而,较小的次级颗粒会引入更大的界面面积,而总热阻与界面面积成正比,因此在固定主颗粒体积分数下,选择较大的次级颗粒能获得更优的热性能。
结论与应用价值
本研究通过晶格玻尔兹曼方法与有限元方法的耦合,系统揭示了金刚石/铜复合材料在微纳米到宏观尺度的传热机制,为高性能热管理材料的制备提供了理论指导。研究确定的22 μm粒径阈值具有重要的工程意义——在制备金刚石/铜复合材料时,应优先选用粒径超过此临界值的金刚石颗粒,以确保充分发挥金刚石的高热导优势。双峰颗粒策略为提升复合材料热导率提供了新思路,通过优化主颗粒与次级颗粒的粒径比(R=3为最佳),可在不显著增加界面热阻的前提下实现热导率的进一步提升。此外,研究还证实了高体积分数金刚石(接近50 vol%)可将复合材料的热膨胀系数降至9 ppm·K⁻¹,显著改善与半导体器件的匹配性,有助于防止热应力导致的变形或开裂。这些发现为新一代高功率电子器件的热管理材料设计提供了重要参考,对推动5G基站、数据中心、新能源汽车电控系统等高热流密度应用场景的热管理技术进步具有重要价值。
论文信息:Y. Zhu, E. Yin, W. Luo, Q. Li. Multiscale thermal analysis of diamond/Cu composites for thermal management applications by combining lattice Boltzmann and finite element methods. International Journal of Thermal Sciences, 2025, 211: 109736. DOI: https://doi.org/10.1016/j.ijthermalsci.2025.109736